上海伯東日本 Atonarp Aston? 過程質(zhì)譜儀應用于半導體光刻技術(shù) EUV 極紫外光源鹵化錫原位定量
EUV 極紫外光刻技術(shù)越來越多地用于支持 <10nm 工藝技術(shù)的關(guān)鍵尺寸圖案形成. 管理這些價值超過 2億美元光刻機的正常運行時間和生產(chǎn)量對晶圓 Fab 廠的經(jīng)濟至關(guān)重要. 上海伯東日本 Atonarp Aston? 過程質(zhì)譜分析儀通過快速, 可操作, 高靈敏度的分子診斷數(shù)據(jù)實現(xiàn)了更佳的反射板鍍錫層清潔, 并且 Aston? 過程質(zhì)譜的實時氫氣 H2 監(jiān)測也降低了每個 EUV 工具的氫氣消耗.
隨著工藝幾何尺寸的不斷縮小, 半導體工藝制造商面臨著新的挑戰(zhàn). 在先進的極紫外 EUV 光刻技術(shù)中, 13.5nm 波長的光源是通過二氧化碳 CO2 激光器蒸發(fā)熔融錫 Sn 液滴, 從而產(chǎn)生等離子體. 大批量生產(chǎn)的關(guān)鍵挑戰(zhàn)包括控制蒸發(fā)錫再沉積引起的光學污染所造成的缺陷.
光源產(chǎn)生的一個副產(chǎn)品是 EUV 光源反射光學元件上的錫 Sn 碎片, 該反射光學元件聚焦等離子體發(fā)出的 EUV光. 收集鏡涂層表面上的錫沉積導致 EUV 鏡的反射率降低. 沉積錫厚度約為 1nm(只有幾個原子層)會使收集鏡反射率降低多達10%, 通常被視為收集鏡壽命規(guī)范. 這種污染增加了提供足夠的 EUV 功率以形成晶圓所需的時間, 因此降低了光刻產(chǎn)量, 并可能影響光刻圖案的定義. 解決措施包括使用氫等離子體 (結(jié)合磁場) 以錫烷氣體 SnH4 的形式化學去除錫, 然后從真空室排氣, 并防止錫進一步再沉積.
上海伯東 Aston? 過程質(zhì)譜 EUV 極紫外光源鹵化錫原位定量解決方案
在反射板清潔期間, 需要實現(xiàn)現(xiàn)場測量, 快速, 準確地測量錫 SnH4 端點, 確保以省時的方式清除錫沉積物, 通過使用 Aston? 過程質(zhì)譜儀可以測量 H2 大氣中 0.01-1 ppm 濃度下的微量 SnH4. 此外, Aston? 還可以監(jiān)測 EUV 工具前端的氣體成分.
Aston? 過程質(zhì)譜價值在于通過監(jiān)測從 EUV 腔室中抽空所有錫原子的效率和優(yōu)化氫氣 H2 流量, 實現(xiàn)終點檢測. 通過盡可能地減少氣體流量, 可以降低每分鐘 100 標準升的高純度氫氣消耗量.
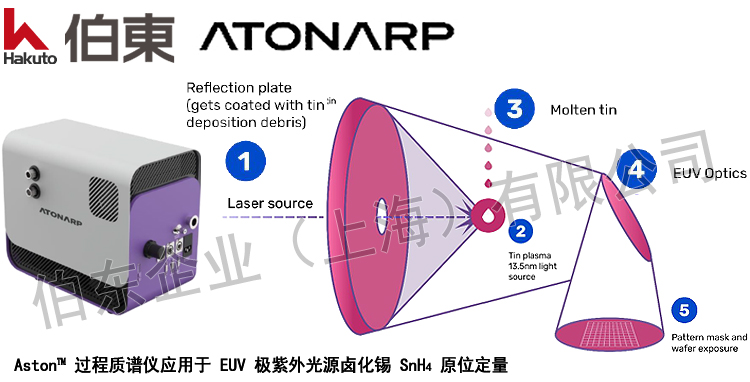
若您需要進一步的了解詳細信息或討論, 請參考以下聯(lián)絡方式:
上海伯東: 羅先生 臺灣伯東: 王女士
T: 86-21-5046-1322 T: 886-3-567-9508 ext 161
F: 86-21-5046-1490 F: 886-3-567-0049
M: 86 152-0195-1076 M: 886-939-653-958
www.hakuto-china.cn www.hakuto-vacuum.com.tw
上海伯東版權(quán)所有, 翻拷必究!