
上海伯東日本 Atonarp Aston? 質譜分析儀無等離子體設計,可以實現快速, 化學特定的原位定量氣體分析, 與光學發射光譜 OES 對比, Aston? 質譜儀 的 OA% 靈敏度顯示為 <0.25%, 適用于半導體工藝中蝕刻計量控制, ALD, 3D-NAND 和新興的堆疊式 DRAM.
半導體蝕刻工藝挑戰日益增加
蝕刻是半導體制造中常用的工藝之一. 介電蝕刻用于形成絕緣結構, 觸點和通孔, 多晶硅蝕刻用于在晶體管中創建柵極, 金屬蝕刻去除材料以顯示電路連接圖案并鉆穿硬掩模.
連續蝕刻鋁 Al, 鎢, 銅 Cu,鈦 Ti 和氮化鈦 TiN 等工藝金屬具有挑戰性, 因為許多金屬會形成非揮發性金屬鹵化物副產品(例如六氯化鎢 WCl6), 這些副產品會重新沉積在蝕刻側壁上, 導致成品率降低(通過微粒污染或沉積材料導致短路).
隨著半導體行業不斷縮小關鍵特征尺寸并采用垂直擴展 (如 3D-NAND 存儲器和全環繞柵極先進技術節點), 各種新的蝕刻挑戰已經出現. 這些包括在晶圓上蝕刻更小的特征, 高展弦比 HAR 溝槽蝕刻 (具有小的開放面積百分比- OA%), 以及在新興的非揮發性存儲器和高 k介質中蝕刻金屬閘極, 稀土金屬等新材料. 對于先進的納米級工藝, 如蝕刻到硅介質和金屬薄膜, 選擇性處理, 如原子層蝕刻 ALE 一次去除材料的幾個原子層. ALE 提供了比傳統蝕刻技術更多的控制. 對于 3D-NAND 和先進 DRAM 來說, 向批量生產過渡的重大挑戰包括解決導體蝕刻困難的要求, 滿足積極的生產斜坡和實現所需的吞吐量, 以推動成本效益.
上海伯東日本 Atonarp Aston? 質譜分析儀提供高性能, 嵌入式和可靠的原位定量分子氣體計量已經成為驗證工藝室和持續監測工藝化學過程的關鍵工具, 確保生產環境中的高產率和更大吞吐量.
Aston? 質譜分析儀提供全腔室解決方案
使用上海伯東 Atonarp Aston? 質譜儀通過實時, 定量和精確的分子傳感器來解決半導體新興蝕刻工藝技術相關的關鍵挑戰. 通過解決傳感器耐久性, 靈敏度, 匹配, 系統集成和易用性等方面的挑戰, 日本 Atonarp Aston? 質譜儀升級了傳統的氣體分析計量方法. Aston 是一種全室解決方案, 用于在各種工藝步驟中實時監測前體, 反應物和副產物.
這些包括基準室和過程指證, 腔室清潔, 過程監測 (包括存在腐蝕性氣體), 顆粒沉積和氣體污染物凝結. 小的占地面積和靈活的通信接口允許在室內安裝和集成到過程設備控制系統. 為了集成到半導體工藝工具中, Aston 質譜分析儀的高性能和可靠性設計用于生產晶圓的大批量生產過程控制.
Aston? 質譜分析儀半導體蝕刻計量控制
半導體行業正從二維結構的擴展轉向復雜三維結構的挑戰性要求. 傳統的離線晶圓測量已不足以實現性能和良率目標, 原位蝕刻測量傳統上缺乏生產所需的魯棒性和可重復性. Aston? 質譜分析儀的結構中嵌入了專利技術, 使其具有卓越的分析和操作性能. 為了滿足過程控制和跨工廠生產工具匹配的嚴格要求, Aston 從頭開始設計, 高運行時間和低維護的吞吐量, 長期信號穩定性和可重復性.
為了承受腐蝕和沉積過程的惡劣環境, Aston? 引入了兩個革命性的功能: 等離子電離和自清潔 (ReGen?模式). 等離子體電離消除了由于與腐蝕性氣體(如NF3, CF4, Cl2)的反應而導致的燈絲降解. 此外, 除去(正硅酸四乙酯) TEOS 等顆粒和蒸汽污染物沉積, 同時定期進行室內清潔循環, 延長了 Aston? 質譜儀的使用壽命. ReGenTM 模式使儀器能夠使用高能等離子離子清洗自身, 通過去除在膜沉積過程中可能發生在傳感器和腔室壁上的沉積. 結合這兩個功能, 傳感器的靈敏度可維持在數百個RF(射頻)小時的操作. Aston質譜儀支持的基于測量的控制, 有可能延長清洗間隔 MTBC 的平均時間. MTBC 的增加意味著工具可用性和長期吞吐量的增加. 除了等離子電離器(用于工藝), 傳感器還配備了傳統的電子沖擊 EI 燈絲電離器, 用于基線和校準.
分子傳感器的分析級是使用微米級精密雙曲電極的四極桿. 由高度線性射頻(RF)電路驅動, Aston 質譜的HyperQuad 傳感器在 2到300 amu的質量范圍內具有更高的分析性能.
Aston? 質譜分析儀技術參數
參數 | 值 |
質量分辨率 | 0.8u |
質量數穩定性 | 0.1u |
靈敏度(FC / SEM) | 5x10-6 / 5x10-4 A/Torr |
最低可檢測的部分 壓力(FC / SEM) | 10-9 / 10-11 Torr |
檢測極限 | 10 ppb |
最大工作壓力 | 1X10-3 Torr |
每 u 停留時間 | 40 ms |
每u掃描更新率 | 37 ms |
發射電流 | 0.4 mA |
發射電流精度 | 0.05 % |
啟動時間 | 5mins |
離子電流穩定 | < ?1% |
濃度的準確性 | < 1% |
濃度穩定 | ?0.5% |
電力消耗 | 350w |
重量 | 13.7kg |
尺寸 | 400 x 297 x 341mm |
高展弦比 HAR 3D 蝕刻
隨著多模式技術和 3D器件結構的出現, 高度密集的蝕刻和沉積過程驅動了計量需求. 3D多層膜棧, 如 NAND 存儲架構, 代表復雜的, 具有挑戰性的蝕刻過程, 具有關鍵的蝕刻角度, 統一的通道直徑和形狀要求, 盡管高蝕刻縱橫比通道 >100:1 是常見的. 對于 3D-NAND, 關鍵導體蝕刻過程包括階梯蝕刻(下圖)和用于垂直通道和狹縫的 HAR 掩模打開. 通過硝酸硅和氧化硅交替層蝕刻需要高速定量終點檢測. 對于 DRAM, 蝕刻過程包括 HAR 門, HAR 溝槽和金屬隱窩. 對于階梯蝕刻, 關鍵是在整個 3D堆棧的每個介質膜對的邊緣創建等寬的“步驟”, 以形成階梯形狀的結構. 在器件加工過程中, 這些步驟的大量重復要求蝕刻高吞吐量和嚴格的過程控制.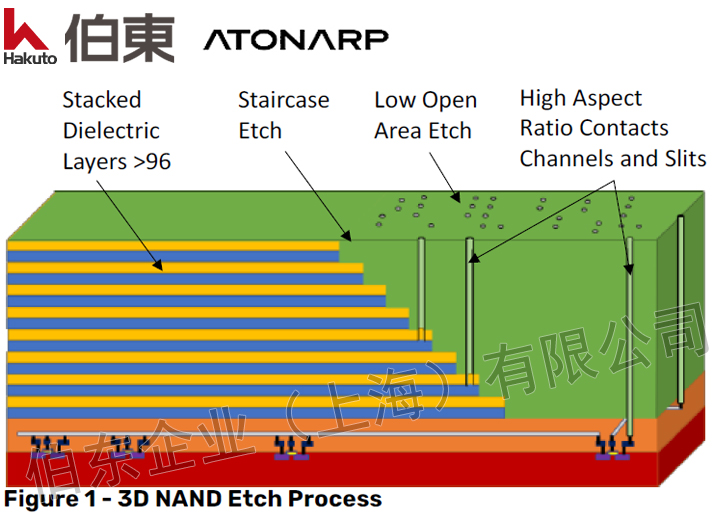
多功能現場氣體計量需要在一個工具中執行多種監測功能:
? 檢測和量化污染, 交叉污染, 氣體雜質和工藝室內的工藝化學
? 評估已開發的蝕刻過程在生產工具 / 運行的復雜功能上的性能
? 測量刻蝕后的清潔 (包括先進的無晶圓自動清潔; WAC) 作為腔條件對于消除工藝漂移和確保可重復性性能是至關重要的
? 快速準確的蝕刻端點檢測 EPD, 通過等離子體或氣體監測, 因為這是一個關鍵的控制功能. 舉例包括一氧化碳 CO 副產物在介電蝕刻中下降或氯 Cl 反應物在多晶硅和金屬蝕刻端點上升.
? 全面的實時計量數據, 允許過程等離子體和反應物的動態腐蝕控制, 以管理要求的腐蝕剖面
Aston? 質譜分析儀無等離子體終點檢測
雖然光學發射光譜 OES 已被廣泛用于蝕刻 EPD, 但低開放面積 OA 和 HAR 設計的趨勢使其在許多蝕刻任務中無效. OES 技術需要等離子體'開'和發光物種. 隨著昏暗和遠程等離子體越來越多地用于 3D設備和原子水平蝕刻 ALE 工藝, 需要更多敏感的數據和分析技術來實現迅速和確定的 EPD. 此外, 脈沖等離子體通常用于管理 HAR 和 低 OA% 工藝的蝕刻剖面, 這使得 OES 對于 EPD 來說是一個不切實際的解決方案. 在3D 結構中, 多層薄膜和多個接觸深度阻礙了每一行觸點到達底部時端點的光學發射信號的急劇步進變化
其他 OES 限制包括:
? 在電介質蝕刻中, 在 OA <5% 的模式上進行 EPD一直具有挑戰性, 因為 OES 在低濃度下具有低信噪比.在高壓Si深蝕刻(例如博世工藝)中, 要求 OA% 的 EPD低于 0.3%, OES 中較大的背景噪聲水平抑制了對發射種數量的任何變化的檢測.
? 在金屬蝕刻中, OA% 可能低于10%, 這取決于所涉及的互連尺寸. 對于接觸和通過蝕刻, OA 可以在0.1-0.5%之間或更低, 這取決于所涉及的特征的大小. 在鎢 W 蝕刻的情況下, 隨著 OA的減小, 氯 Cl 反應物的消耗減少, 由于材料運輸到 HAR 蝕刻特征, 蝕刻趨于放緩. 這兩個因素都降低了反應氣的消耗率. 因此, 由于等離子體中反應物的耗盡, 很難看到在終點處 OES信號的顯著變化.
Aston? 質譜儀可以利用蝕刻反應物和 EPD 的副產物. 此外, Aston 能夠在小的, 有限體積的傳感器上運行周期性清洗, 以保持其性能(靈敏度), 在延長晶圓運行次數的情況下獲得更大的正常運行時間. 然而, OES 要求在腔室上有一個需要保持清潔的訪問窗口,以獲得足夠強度的穩定信號。通常,加熱石英窗用于減緩工藝產品的堆積. 使用 Aston?質譜分析儀,在低濃度下的檢測不受等離子體發射的背景光譜的影響, 也不受射頻功率脈沖期間等離子體強度波動的影響.
圖 3a/3b 顯示了 CO 和 SiF3 的副產物 OA%下降到0.25%的電介質腐蝕EPD數據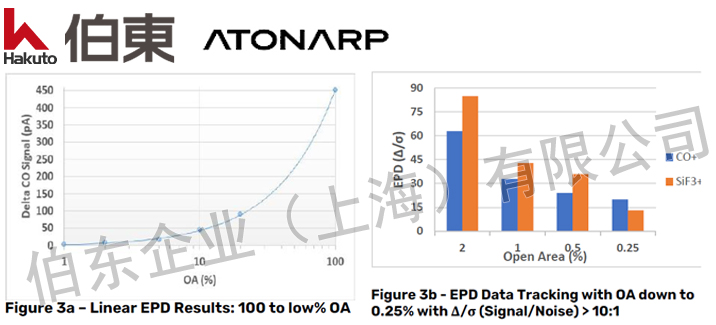
數據清楚地顯示了線性行為和在低濃度下的檢測不受等離子體發射的背景光譜影響. Aston 質譜的 ppb 靈敏度是針對 0.1%以下的 OA性能.
原子級蝕刻 ALE
在三維結構中, ALE 過程中的逐層去除需要脈沖射頻電源來控制自由基密度和較低的離子能量, 以減少表面損傷和保持方向性. 在這樣的光源中, 等離子體的整體光強較低, 并表現出波動幅度. 通常等離子體離晶圓區很遠(>距晶圓區25厘米), 而且等離子體激發的副產物很少, 使得光學測量不切實際.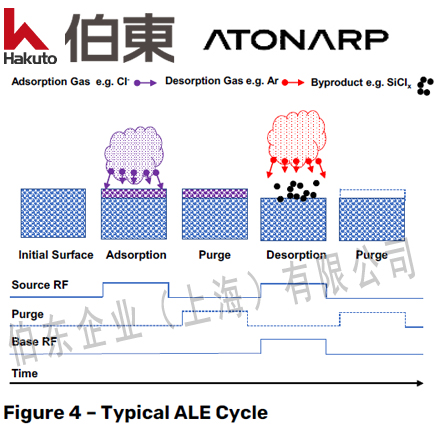
在 ALE中, 由于每個周期都是自我限制的, 端點檢測可能不那么重要. 然而, 在缺乏氣體分析的情況下, 工藝工程師對監測腔室和工藝健康狀況“視而不見”, 因為無法看到化學狀態, 特別是在工藝步驟 (吸附/凈化/反應/凈化) 之間過渡時的動態狀態, ALE 的自限性并不能使它不受過程漂移的影響. 此外, 由于 ALE 不是基于等離子體的, 因此過程中的化學變化不一定可以通過等離子體監測檢測到.
有一種誤解, 認為 ALE 技術實際上是一次一個原子層; 相反, 它們每循環的去除/沉積量可能比單分子膜多一點(或少一點). 由于真空泵性能, 晶圓溫度或離子轟擊能量 (電壓) 的變化分別導致表面飽和度和表面反應性的變化, 工藝移位(?/周期的變化)可能發生.
在 ALE (下圖)中,由于等離子體的使用不一致, 化學監測方面的差距就不那么明顯了. 在這種情況下, Aston? 質譜儀具有以下優點:
? 在每個工藝步驟中建立一個腔室化學狀態的指證. 這可以參照其自身的正常行為, 也可以參照標準腔
? 描述和監控與化學變化相關的動態過程中, 從一個步驟過渡到下一個步驟
? 監測在 ALE 循環第一步之后從系統中清除吸附物質的時間. 等離子體通常用于產生吸附物質(自由基), 但它是在遠離晶圓片的地方產生的
? 監測 ALE 循環第二步反應產物的變化. 等離子體光強通常較低, 因為它使用了低占空比的脈沖射頻
? 監測反應產物和反應物在ALE循環第二步后被凈化的時間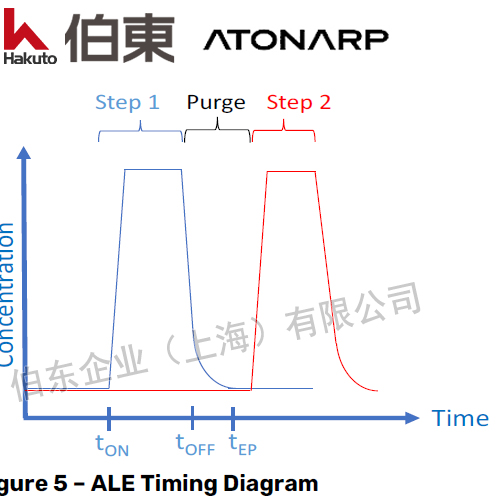
結論
原子級蝕刻只能使用像上海伯東日本 Atonarp Aston? 質譜儀這樣的分子傳感器進行真正的測量和監測. 它的高靈敏度, 速度和對等離子體強度變化的低敏感性產生可靠的定量測量, 即使在低濃度的反應物和副產物, 具有低于1% 水平的高精度, 可以監測微妙的過程漂移和過程變化效應, 提供了可用于機器學習模型的見解.
利用其高掃描速度, 通過監測反應產物減少的時間來實現步進時間優化, 因為它是表面反應活性變化的指示, 增加了總體吞吐量.
ALE 是先進的蝕刻技術, 上海伯東 Aston 質譜儀為 ALE 提供了先進的化學計量技術, 可以測量和控制反應及其持續時間, 為大批量生產提供了可靠的解決方案.若您需要進一步的了解詳細信息或討論, 請參考以下聯絡方式:
上海伯東: 羅先生 臺灣伯東: 王女士
T: 86-21-5046-1322 T: 886-3-567-9508 ext 161
F: 86-21-5046-1490 F: 886-3-567-0049
M: 86 152-0195-1076 M: 886-939-653-958
www.hakuto-china.cn www.hakuto-vacuum.com.tw
上海伯東版權所有, 翻拷必究!
業務咨詢:932174181 媒體合作:2279387437 24小時服務熱線:15136468001 盤古機械網 - 全面、科學的機械行業免費發布信息網站 Copyright 2017 PGJXO.COM 豫ICP備12019803號